Ruoyu WANG, Fuyang YAN, Tundong LIU. Rapid and uniform exposure control for wafer motion imaging system[J]. Optics and Precision Engineering, 2024, 32(19): 2933
Search by keywords or author
- Optics and Precision Engineering
- Vol. 32, Issue 19, 2933 (2024)
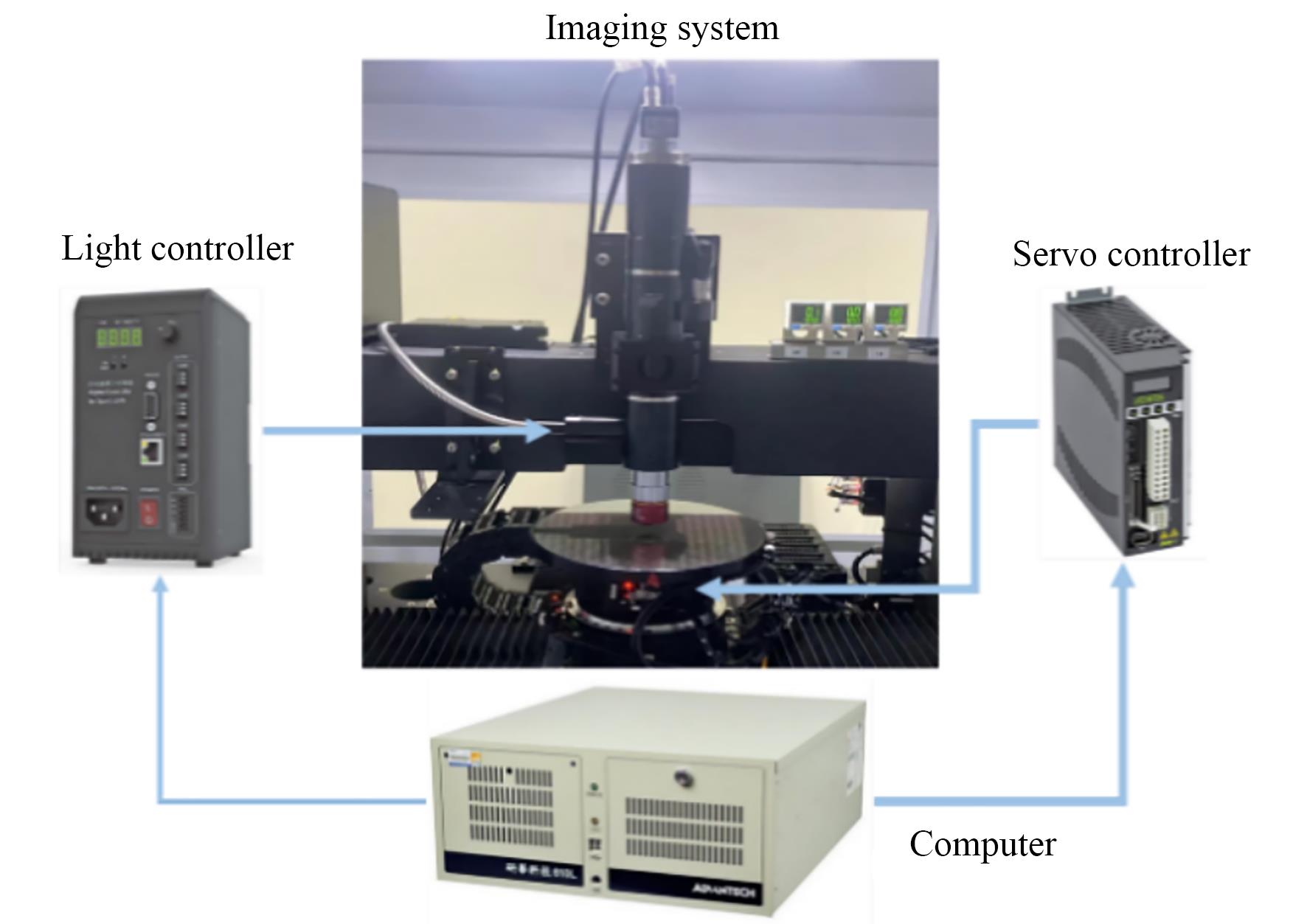
Fig. 1. Composition of wafer motion imaging system

Fig. 2. Process of wafer motion imaging exposure control
Fig. 3. Image of typical die
Fig. 4. Image segmentation using OTSU algorithm
Fig. 5. Image segmentation using blocked OTSU algorithm
Fig. 6. Trend of classes variance with different block quantities
Fig. 7. High and low frequency components of die images under different brightness
Fig. 8. Comparison of normalized evaluation values before and after Gaussian pyramid down sampling
Fig. 9. Relationship between dynamic weight and grayscale
Fig. 10. Process of search algorithm
Fig. 11. Pseudocode for step size selection program
Fig. 12. Different evaluation curves for three types of dies
Fig. 13. Comparison of exposure effects of different methods in different regions
|
Table 1. Sensitivity coefficients in different regions
| |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 2. Best exposure image indicators obtained by different evaluation methods
| ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 3. Indicators for different search methods
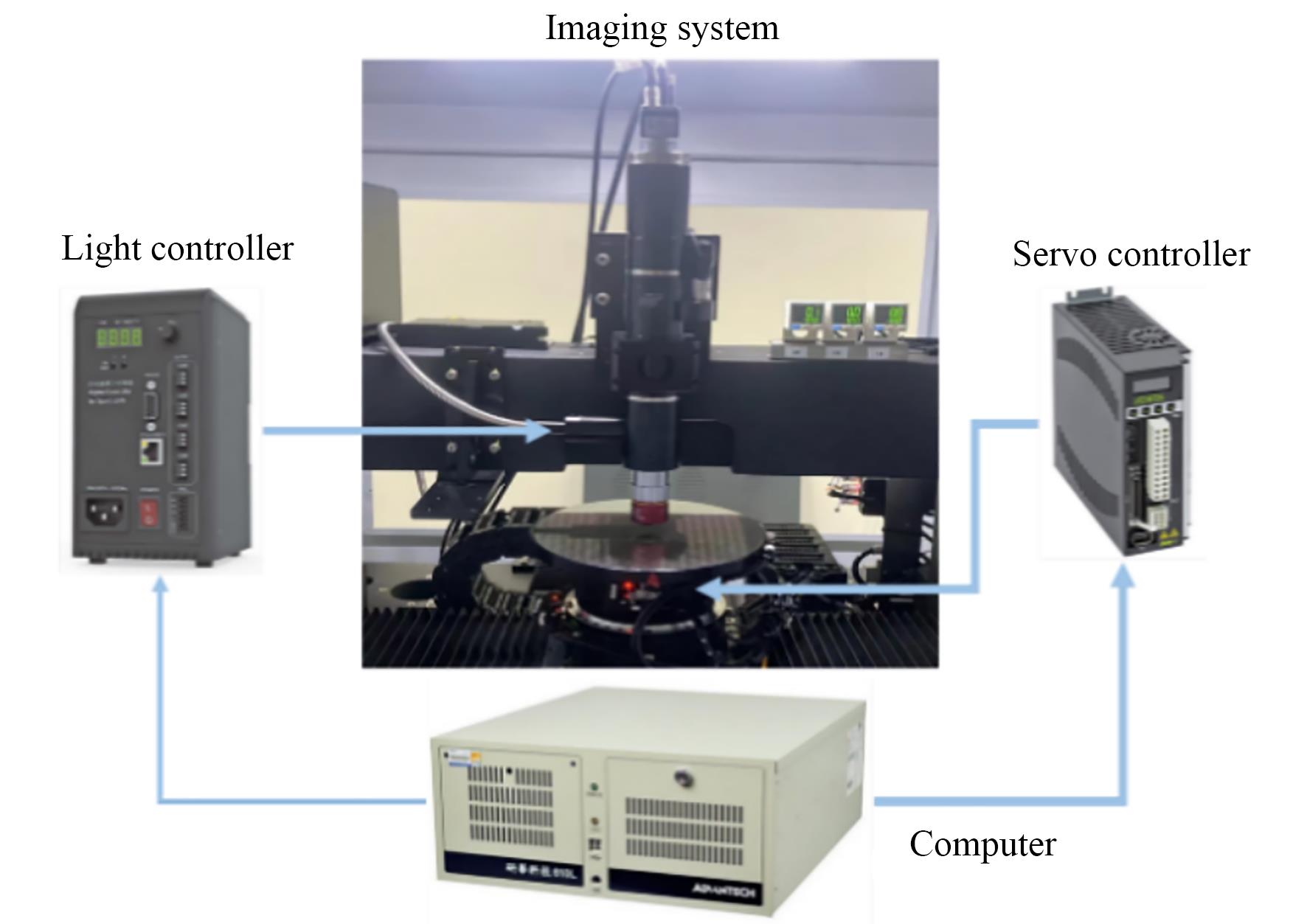
Set citation alerts for the article
Please enter your email address



